如果你需要购买磨粉机,而且区分不了雷蒙磨与球磨机的区别,那么下面让我来给你讲解一下: 雷蒙磨和球磨机外形差异较大,雷蒙磨高达威猛,球磨机敦实个头也不小,但是二者的工
随着社会经济的快速发展,矿石磨粉的需求量越来越大,传统的磨粉机已经不能满足生产的需要,为了满足生产需求,黎明重工加紧科研步伐,生产出了全自动智能化环保节能立式磨粉
 追求更高效率的300 mm研磨拋光机 DISCO HITEC CHINA
追求更高效率的300 mm研磨拋光机 DISCO HITEC CHINA
2015年3月11日 本机型实现了背面研磨到去除参与应力技术的一体化,可以稳定地实现厚度在25 μm以下的薄型化加工。 还配置了新开发的主轴,适用于高速研削加工。 有助于缩短薄
 减薄精加工研削 研削 解决方案 DISCO
减薄精加工研削 研削 解决方案 DISCO
通过将原来的第一主轴上粗加工研削用磨轮所使用的陶瓷类结合剂(VS,VS202等)改变成树脂类结合剂BT100(照片4),就能够降低晶片的破损率,并使导致晶片开裂的边缘崩裂现象 ※1 也得到了控制。 另外,
 DFG8640 研磨機 產品介紹 DISCO Corporation
DFG8640 研磨機 產品介紹 DISCO Corporation
高精度研磨 部分的功率元件和Sensor,會因為研磨後的厚度誤差 (單片晶圓內,或是晶圓與晶圓之間的誤差)影響產品特性,而需要高精度的研磨能力。 DFG8640透過加工點規劃佈局的最佳化,及搭載了各種機構而實現了高
 減薄精加工研磨 研磨 解決方案 DISCO
減薄精加工研磨 研磨 解決方案 DISCO
如照片1所示,只對Φ300 mm矽晶片進行研磨加工,就可將晶片的厚度減薄加工至5 µm。通過將本期介紹的設備,磨具以及研磨條件進行最佳組合,即使只使用通常的研磨方式也能夠減薄加工到這麼薄的程度。 照片1 t5 µm
 研磨 解決方案 DISCO Corporation
研磨 解決方案 DISCO Corporation
近年,隨著在手提電話等數位式,移動式小型電器中SiP(System in Package)等電子元件的使用日趨普及,在保持高良率的條件下,針對厚度在100 µm以下晶片的減薄精加工研磨
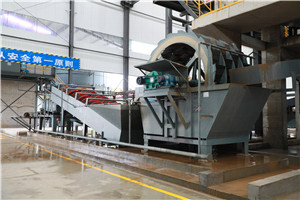 dfg8340 cn t DC DISCO HITEC CHINA
dfg8340 cn t DC DISCO HITEC CHINA
2023年12月11日 可對應高精度少量的研磨加工 實現穩定的晶圓高精度加工 隨著電子元器件高積體化的發展,追求高平坦度的晶圓製造工程中也逐漸開始採用表面研磨(Grinding )
 DISCO Corporation
DISCO Corporation
2019年3月6日 实现高精确度研磨 由于部分功率元件或感测元件研磨后所产生的厚度偏差(不同晶圆间的 偏差,单片晶圆内的偏差)将对制品特性产生影响,致力于追求高精确
 dis研磨机可以研磨到多少厚度
dis研磨机可以研磨到多少厚度
给你一台研磨机,你怎么管控厚度? 知乎2022年5月31日 这 研磨机 最终的便是作用 可见 研磨机 的作用仍是有很大的作用的,一款7774A 研磨机 具备以下几点要求: 1设备自身装备行走功用,无需操作者对研磨设备进 半导体封装工艺讲解ppt背面研磨(Back Grinding)决定晶圆
 dis研磨机可以研磨到多少厚度
dis研磨机可以研磨到多少厚度
通過將本期介紹的設備,磨具以及研磨條件進行最佳組合,即使只使用通常的研磨方式也能夠減薄加工到這麼薄的程度。 照片1 t5 µm 減薄精加工研磨 研磨 解決方案 DISCO 提高抗折强度(去除应力加工) 虽然通过采用Poligrind磨轮进行研削加工,可提高减薄精加工的加工质
 DFG8540 研磨機 產品介紹 DISCO Corporation
DFG8540 研磨機 產品介紹 DISCO Corporation
追求100um以下的超薄精密研磨 透過最佳化研磨及搬運參數,實現了穩定的超薄研磨加工。 可對應超薄精密研磨製程的系統擴充性 可對應DBG(Dicing Before Grinding=先切割,後研磨),以及和乾式拋光機(DFP8140)組成聯機系統。 繼承了廣受好評的研磨機規格
 減薄精加工研磨 研磨 解決方案 DISCO Corporation
減薄精加工研磨 研磨 解決方案 DISCO Corporation
雖然通過採用Poligrind磨輪進行研磨加工,可提高減薄精加工的加工品質。 但由於使用的是磨輪,所以在晶片表面仍然會殘留下細微的破碎層。 為了去除表面殘留的破碎層,進一步提高晶片的抗折強度,迪思科公司還可以根據客戶的要求,提供各種不同的去除
 半导体切磨抛设备前景展望 DISCO:全球半导体切磨抛设备
半导体切磨抛设备前景展望 DISCO:全球半导体切磨抛设备
2024年2月4日 DISCO:全球半导体切磨抛设备材料巨头专注半导体切割、研磨、抛光八十余载,产品布局完善日本迪 思科 株式会社( DISCO Corporation )成立于 1937 年,是一家专注于“Kiru(切)、 Kezuru(磨)、Migaku(抛)”技术的全球知名半导体设备厂商。
 DFG8640 研磨機 產品介紹 DISCO Corporation
DFG8640 研磨機 產品介紹 DISCO Corporation
高精度研磨 部分的功率元件和Sensor,會因為研磨後的厚度誤差(單片晶圓內,或是晶圓與晶圓之間的誤差)影響產品特性,而需要高精度的研磨能力。DFG8640透過加工點規劃佈局的最佳化,及搭載了各種機構而實現了高精度研磨。 可用於最大直徑8吋的各種材料
 先进封装设备之争 日本减薄机独领风骚,国产研磨机步步紧逼
先进封装设备之争 日本减薄机独领风骚,国产研磨机步步紧逼
2023年7月15日 通过背面研削到去除应力的一体化,可以稳定地实施厚度在25 μm以下的薄型化加工 图源: DISCO 除了在硅片制造和晶圆制造环节,在封测背面减薄环节中,DISCO背面研磨机用于晶圆的背面研磨以使其变薄,同时保护正面的电路;损坏的层可以通过抛光去除以提高减薄晶片的强度,在此过程中DISCO 抛光
 研磨 解決方案 DISCO Corporation
研磨 解決方案 DISCO Corporation
減薄精加工研磨 近年,隨著在手提電話等數位式,移動式小型電器中SiP(System in Package)等電子元件的使用日趨普及,在保持高良率的條件下,針對厚度在100 µm以下晶片的減薄精加工研磨技術正在日益受到市場的矚目。 迪思科公司通過對各種各樣的設備,磨
 DISCO推出新型自动研磨机,可加工8英寸SiC晶圆 艾邦
DISCO推出新型自动研磨机,可加工8英寸SiC晶圆 艾邦
6 天之前 1月 25, 2024 1月25日,迪斯科中国官微消息,为针对Si以及SiC等8英寸以下的晶圆,开发了双主轴全自动研磨机「DFG8541」。 该机型为畅销研磨机「DFG8540」的升级机型,实现了更为稳定的高产能减薄加工。 同时,与DFG8540相比,进一步完善了清洗结构,提高了维护
 Microsoft PowerPoint dfg8540 8560cppt DISCO HI
Microsoft PowerPoint dfg8540 8560cppt DISCO HI
2021年7月6日 DFG8540/8560配置了触摸式液晶显示器及图 形化用户接口GUI(Graphical User Interface),提高了操作便利性。 而且设备的 机械状态和加工状况可在控制画面上同步显 示。 操作人员通过触摸控制画面上的图形化按 钮, 就可以简单地完成操作, 不但加快了作业 速度, 还使设备
 DFG8340 研磨機 產品介紹 DISCO Corporation
DFG8340 研磨機 產品介紹 DISCO Corporation
穩定的晶圓高精度加工 隨著產品元件高積體化的發展,追求高平坦度的晶圓製造工程中也開始採用表面研磨 (Grinding)技術。 作為在世界各地備受好評的DFG830後繼機種的DFG8340,透過搭載高剛性主軸並將加工時所產
 DISCO:一家少被提及的半导体设备巨头硅片刀片研磨机
DISCO:一家少被提及的半导体设备巨头硅片刀片研磨机
2022年7月24日 DISCO:世界级封测设备巨头 DISCO是一家日本公司,其核心竞争力是将制造的半导体硅片研磨成更薄的硅片,然后将其切割成die,然后组装成电子产品。 他们的公司座右铭是 Kiru, Kezuru, Migaku,意思是切割、研磨和抛光。 DISCO 在晶圆研磨机、砂轮、晶圆切割锯
 晶圆背面研磨与湿式刻蚀应力消除工艺
晶圆背面研磨与湿式刻蚀应力消除工艺
2018年7月6日 在研磨时遭受机械研磨与热应力,所产生之应力损伤层分 布,一般应力损伤层厚度为10~25μm。为了消除晶圆应力、去除损伤层及翘曲,进而增加晶 圆强度。一般在晶圆研磨后会进行后续消除损伤层步骤,例如 :(1)研磨后进行抛光、退火;(2)研磨后进行
 DBG (Dicing Before Grinding)工艺 解决方案 DISCO HI
DBG (Dicing Before Grinding)工艺 解决方案 DISCO HI
在通常的切割加工中,会切割到晶片背面,直至完全切断。但是,在实施DBG工艺时,可以切割到所要求的芯片厚度 尺寸为止。 完成半切割加工作业之后,先在晶片表面粘贴保护胶膜,再使用研削机进行背面研削加工。当研削到事先切入的切割槽时,晶片
 减薄研磨机 ACCRETECH
减薄研磨机 ACCRETECH
2021年10月18日 东京精密减薄研磨机 为将晶圆减薄到一定厚度,晶圆的图形面会贴上一层保护胶带,然后用磨轮和抛光材料对晶圆背面进行研磨。 由于半导体材料用晶圆越来越薄,传统的研磨机已经不能满足使用要求。 Accretech 的PG 系列可以抛光超薄晶圆,和RM系统的连接,
 DBG(Dicing Before Grinding)製程 DBG(Dicing Before
DBG(Dicing Before Grinding)製程 DBG(Dicing Before
DBG就是將原來的「背面研磨 →切割晶片」的製程程序進行逆向操作,先對晶片進行半切割加工,然後利用背面研磨使晶片分割成晶粒的技術。 經通運用該技術,能有效地抑制分割晶片時產生的背面崩裂及晶片破損,從而能夠順利地從大尺寸的晶片上切割出晶粒。
 半导体行业专题研究报告:半导体切磨抛装备材料的国产化趋势
半导体行业专题研究报告:半导体切磨抛装备材料的国产化趋势
2023年3月2日 一、DISCO:全球半导体切磨抛设备材料巨头 (一)专注半导体切割、研磨、抛光八十余载,产品布局完善 日本迪思科株式会社(DISCO Corporation)成立于 1937 年,是一家专注于“Kiru(切)、 Kezuru(磨)、Migaku(抛)”技术的全球知名半导体设备厂商。 公司产品
 胶体磨可以磨出细度多少目(微米)
胶体磨可以磨出细度多少目(微米)
2023年7月28日 昊星胶体磨是一种干湿两用超微粒研磨机,因顺应国家提倡环保节能的国情要求一般采用湿法粉碎研磨出料细度能达到2007000目 (260um)微米级,甚至有些易碎流体含小颗粒物,经过昊星研制纳米锥体磨能研磨达到nm纳米级细度。 详细介绍一下昊星胶体磨研
 研磨可使工件精度达到多少毫米 常见问题 方达研
研磨可使工件精度达到多少毫米 常见问题 方达研
2014年6月5日 平面研磨是运用物理和化学相结合的原理,运用研磨砂轮,研磨液等和工件之间相互摩擦进行作业;一般来说,平面研磨后精度可达到0002mm或者0mm,分别是指平面度和光洁度。 外圆研磨相
 disco研磨机
disco研磨机
减薄研磨机 ACCRETECH, 减薄研磨机 东京精密减薄研磨机 为将晶圆减薄到一定厚度,晶圆的图形面会贴上一层保 护胶带,然后用磨轮和抛光材料对晶圆背面进行研磨。由于半导体材料用晶圆越来越薄,传统的研磨机已经 不能满足使用要求。
 GF01 研磨輪 產品介紹 DISCO Corporation
GF01 研磨輪 產品介紹 DISCO Corporation
通過採用最新金屬磨輪圈, 獲得最佳的使用壽命 迪思科公司最新開發出面向縱向切入式研削機的GF01磨輪系列。 通過採用本公司獨創的新金屬磨輪圈,與原有IF系列產品相比較,能夠高效率地向加工部位供給研削水。 從而獲得穩定的研削性及最佳磨輪使用壽命
 TAIKO工艺 TAIKO工艺 研削 解决方案 DISCO Corporation
TAIKO工艺 TAIKO工艺 研削 解决方案 DISCO Corporation
解决方案 TAIKO工艺,于以往的背面研削不同,在对晶圆进行研削时,将保留晶圆外围边缘部分(约3 mm左右),只对圆内进行研削薄型化的技术。
 dfg8340 cn t DC DISCO HITEC CHINA
dfg8340 cn t DC DISCO HITEC CHINA
2023年12月11日 料的研磨加工。從Lapping到Grinding的置換 通常的Lapping是採用游離磨粒進行批量加工的製程,難以 控制最終加工厚度 。DFG8340可即時測定晶圓厚度,並且只使用純水進行加工,能夠在降低環境負荷的同時提高加工品質。DFG8340 Fully
 TAIKO工艺 解决方案 DISCO HITEC CHINA
TAIKO工艺 解决方案 DISCO HITEC CHINA
TAIKO工艺 TAIKO工艺,是我公司开发的晶片背面研削的新技术。 这项技术和以往的背面研削不同,在对晶片进行研削时,将保留晶片外围的边缘部分(约3mm左右),只对圆内进行研削薄型化。 通过导入这项技术,可实现降低薄型晶片的搬运风险和减少翘曲的作用。
 DAG810 研磨機 產品介紹 DISCO Corporation
DAG810 研磨機 產品介紹 DISCO Corporation
最大可加工到直徑8吋的工作物。 節省空間的設計 機台尺寸為600(W)×1,700(D)×1,780(H)mm。實現了占地面積僅為102 m 2 的小型化設計。 可實現更精密研磨結果的機構及研磨方式 透過採用高剛性,低振動的主軸實現了更好的研磨加
 知乎专栏 随心写作,自由表达 知乎
知乎专栏 随心写作,自由表达 知乎
 WaferThinning 一般研磨 Non iST宜特
WaferThinning 一般研磨 Non iST宜特
2018年8月1日 MOSFET晶圆减薄(wafer thinning)的背面研磨工艺中BG,利用研磨轮,进行快速而精密之研磨 Grinding后,再以蚀刻液进行表面微蚀刻,藉以去除因研磨产生的破坏层,并释放应力。宜特可为客户提供厚度
 研磨百度百科
研磨百度百科
研磨方法一般可分为 湿研、干研 和 半干研 3类。 ①湿研:又称 敷砂研磨,把液态研磨剂连续加注或涂敷在研磨表面,磨料在工件与研具间不断滑动和滚动,形成 切削运动。湿研一般用于粗研磨,所用微粉磨料粒度粗
 知乎专栏 随心写作,自由表达 知乎
知乎专栏 随心写作,自由表达 知乎
 DISCO DFG 8560 晶圆研磨、抛光机 用于销售价格 #
DISCO DFG 8560 晶圆研磨、抛光机 用于销售价格 #
2017年2月7日 DISCO DFG8560的研磨机构由一对平行于每个铣轮的两个高精度线性滑轨和一对两个伺服电机组成。线性幻灯片将wafe移动到所需的铣削位置。伺服电机将铣轮驱动到晶圆研磨的正确位置。线性幻灯片的分辨率为05 um,可重复性精度为1 um。在DFG 8560 研磨
 晶圆研磨设备市场规模 [2024 至 2031] 份额、趋势、增长和
晶圆研磨设备市场规模 [2024 至 2031] 份额、趋势、增长和
晶圆研磨设备市场报告概述 2022年全球晶圆研磨设备市场规模迅速扩大,根据我们的研究,预计到2031年该市场将产生可观的收入,在预测期内复合年增长率强劲。 全球 COVID19 大流行是前所未有的、令人震惊的,与大流行前的水平相比,所有地区的晶圆研磨设备
 研磨(grinding)研磨技术的发展研磨加工技术仪器网 yiqi
研磨(grinding)研磨技术的发展研磨加工技术仪器网 yiqi
因而,研磨可以表述为:利用磨具通过磨料作用于工件表面,进行微量加工的过程。研磨技术的发展 研磨加工除了加工精度和加工质量高这一特点外,还具有加工材料广,几乎可以加工任何固态材料的特点。正是由于这一特点,研磨加工方法的应用比较早。
 太鼓超薄研磨完整解决方案 (Taiko Grinding Total Solution)
太鼓超薄研磨完整解决方案 (Taiko Grinding Total Solution)
藉由太鼓超薄研磨 (Taiko Grinding) 技术,可为客户提供达仅50um的超薄厚度之晶圆,并利用湿蚀刻 (Spin Etching) 进行去除芯片表面因研磨产生的破坏层。 同时一站式的为客户整合后段封装工程,将晶圆进行真空贴片 (Vacuum Mount)、太鼓环移除 (Taiko Ring Remove)。
 如何使用双面研磨机研磨平行度要求很高的工件
如何使用双面研磨机研磨平行度要求很高的工件
2014年11月29日 2u是双面研磨机上一个较难突破的精度值,就国内目前的水平,能将此数值达到2u的平面研磨机生产厂家也是屈指可数。所以这也是未来我国研磨 技术研究和突破的一个重点。 单面研磨机精度不能达到要求的原因及消除方法: